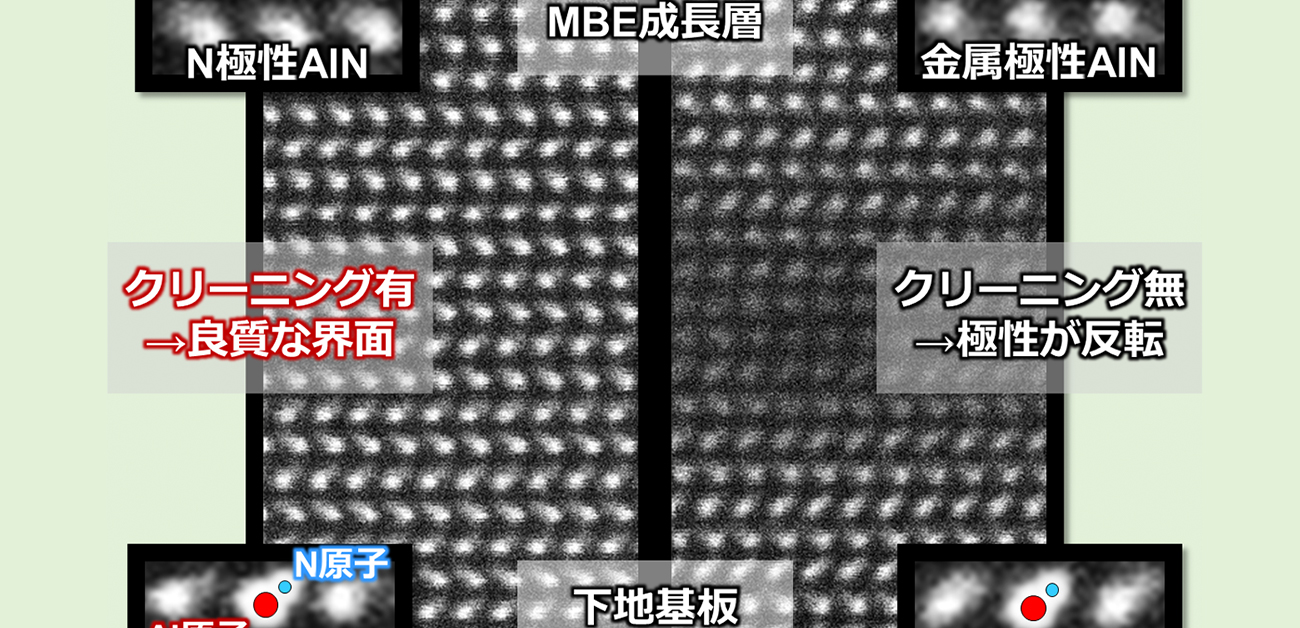
6G用の高速パワーデバイスへ! N極性でGaN on AlNを世界で初めて実現!
大面積・低コストでの実現を視野に
研究成果のポイント
- 省エネルギー半導体材料である窒素(N)極性窒化アルミニウム上窒化ガリウム(N極性GaN on AlN)の大面積・低コストな製造に世界で初めて成功
- 下地基板の表面酸化膜をクリーニングすることで極性を引き継いだ良質なN極性AlNの結晶成長に成功、クリーニングの作用メカニズムを原子スケールの分解能で解明
- N極性GaN on AlNの長所である高密度の2次元電子ガスを実現することで、第6世代移動通信システム(6G)向け高速パワーデバイスの普及に貢献
概要
大阪大学大学院基礎工学研究科の林侑介助教、藤平哲也准教授、酒井朗教授、三重大学大学院工学研究科の三宅秀人教授、コーネル大学のZexuan Zhang氏、Yongjin Cho博士、Huili Xing教授、Debdeep Jena教授らの研究グループは、省エネルギー半導体材料である窒素極性窒化アルミニウム上窒化ガリウム(N極性GaN on AlN)の大面積・低コストな製造に世界で初めて成功しました。
これまでのGaN on AlNは安定な金属極性面の結晶成長のみで実現されてきました。一方、パワーデバイスで優れた特性を期待できるN極性面の結晶成長は不安定で難しいという問題がありました。
今回の研究では、N極性GaN on AlNを実現するため2インチ径の大面積・低コストなN極性AlN下地基板を開発しました。さらに、下地基板の表面を新規手法「Al援用クリーニング」によって清浄化することで、結晶成長中にN極性から金属極性に反転してしまう問題を解決しました。この結果、下地基板の極性を引き継いだ良質なN極性AlN(図1)およびGaN on AlNを分子線エピタキシー(MBE)法で結晶成長することに世界で初めて成功しました。N極性GaN on AlNはシート状に分布した高移動度電子「2次元電子ガス」を高密度に蓄積できるため、6G向け高速パワーデバイスへの応用が期待できます。
本研究成果は、米国科学誌「Science Advances」に、9月10日(土)午前3時(日本時間)に公開されました。
図1. Al援用クリーニングを行うことで良質なN極性AlNの結晶成長成長に成功
研究の背景
省エネルギー半導体材料である窒化ガリウム(GaN)は、現在主流のトランジスタ材料であるシリコン(Si)を代替する存在として期待されています。特に電力変換に特化した「パワーデバイス」では大きな省エネルギー効果を期待できます。これまでのGaNトランジスタは、窒化アルミニウム(AlN)との混晶である窒化アルミニウムガリウム(AlGaN)との界面に蓄積される高移動度電子「2次元電子ガス」を利用することで高速パワーデバイスを実現してきました。2次元電子ガスの密度はGaNとAlGaNの電気分極差に応じて上昇します。通常、AlGaN中のAlN比率は20%で十分に高い導電性を得ることができますが、第6世代移動通信システム(6G)で高速通信の需要が高まるにつれて、導電性をさらに向上させる試みがなされてきました。そのなかでGaNをAlN基板上に結晶成長する「GaN on AlN」は、AlN比率を100%にすることで高密度の電荷蓄積を実現できるアプローチとして注目されています。
GaN on AlNが性能を発揮する結晶面には「金属極性面」と「窒素(N)極性面」の2つがあります。このうち、これまでの研究開発は安定な金属(GaもしくはAl)極性面に限定されていました。一方、N極性面は酸素不純物が起点となって結晶成長中に容易に金属極性へ反転してしまう問題がありました。N極性GaN on AlNは高速パワーデバイスとして高い性能が予想されているため、N極性AlNを安定に結晶成長させるためのブレークスルーが望まれていました。
研究の内容
本共同研究グループでは、まず、2インチ径の大面積・低コストなN極性AlN下地基板を開発しました。大口径のサファイア基板上に安価なスパッタ法でAlN薄膜を堆積し、対面式アニールを施すことで高品質な下地基板を作製できます。これにより、高価なAlN単結晶基板を使用せずにN極性GaN on AlNを実現できます。
さらに、下地基板表面を「Al援用クリーニング」で清浄化することで、表面酸化膜由来の酸素不純物がN極性を金属極性に反転させてしまう問題を解決しました。これは、高真空チャンバー内で極薄のAlを成膜することで表面酸化膜を還元して揮発させる手法です。同チャンバー内で続けて分子線エピタキシー(MBE)法による結晶成長を行うことで、N極性AlNおよびGaN on AlNの作製に成功しました。透過電子顕微鏡による原子配列観察から、下地基板の極性を引き継いだ良質なN極性AlNを成膜できていることを実証しました(図1)。一方、クリーニングを施さなかった試料ではN極性から金属極性に反転する様子が捉えられたことから、クリーニングの作用メカニズムを原子スケールの分解能で解明しました。
今回作製したN極性GaN on AlN試料では、GaN/Al0.9Ga0.1Nからなる2次元電子ガス蓄積層をAlN下地基板上に結晶成長し、3.6×1013 cm-2の電子密度を観測しました。この値は、理論計算の4.2×1013 cm-2と一致することから、電気分極差に由来する2次元電子ガスであることが実証されました。
本研究成果が社会に与える影響(本研究成果の意義)
本研究成果により、N極性GaN on AlNを低コスト・大面積に作製できることが実証されました。この技術的ブレークスルーを6G向け高速パワーデバイスに応用することで、次世代高速無線通信を低消費電力かつ安価に提供できることに繋がります。さらに、今回実証した成果の応用先はパワーエレクトロニクスにとどまらず、発光ダイオードなどの光エレクトロニクスでも利用できる普遍的な技術であるため、GaNに代表される窒化物半導体の社会実装を大きく前進させる重要なマイルストーンとなります。
特記事項
本研究成果は、2022年9月10日(土)午前3時(日本時間)に米国科学誌「Science Advances」(オンライン)に掲載されました。
タイトル:“Molecular beam homoepitaxy of N-polar AlN: enabling role of Al-assisted
surface cleaning”
著者名:Zexuan Zhang, Yusuke Hayashi, Tetsuya Tohei, Akira Sakai, Vladimir Protasenko, Jashan Singhal, Hideto Miyake, Huili Grace Xing, Debdeep Jena, and YongJin Cho
DOI:https://doi.org/10.1126/sciadv.abo6408
なお、本研究は文部科学省「地域イノベーション・エコシステム形成プログラム」、JSPS科研費19K15045の助成、「文部科学省マテリアル先端リサーチインフラ事業(大阪大学 マテリアル先端リサーチインフラ 設備供用拠点)」(課題番号JPMXP09A21OS0036)の支援を受けました。
参考URL
SDGsの目標
用語説明
- 窒素(N)極性
窒化ガリウム(GaN)に代表される六方晶ウルツ鉱型の窒化物半導体はc軸方向に反転対称性をもたないため、金属極性とN極性の2種類の結晶方向が存在する。安定な金属極性での結晶成長が主流だが、高速パワーデバイスで高い性能を期待できるN極性での結晶成長に注目が集まっている。
- 窒化アルミニウム上窒化ガリウム(N極性GaN on AlN)
窒化ガリウム(GaN)、窒化アルミニウム(AlN)はともに六方晶ウルツ鉱構造をもつ窒化物半導体で、それぞれ3.4 eV、6.0 eVのバンドギャップエネルギーをもつ。GaNをAlN基板上に成長させるGaN on AlNでは、既存のGaNトランジスタよりも高密度の2次元電子ガスおよび2次元正孔ガスを発生させることができるため、次世代の高速パワーデバイスの材料系として期待されている。
- 2次元電子ガス
半導体のヘテロ接合界面に生じるシート状の高移動度電子。AlGaN/GaN界面の2次元電子ガスは約2000 cm2V-1s-1の優れた電子移動度を実現できる。AlGaN中のAlN比率を上昇させるとGaNとの電気分極差が大きくなり電子密度を増やすことができるが、GaNとの格子定数差も大きくなり高品質な結晶成長が難しくなるため、一般に20~30%のAlN比率が使用されている。




