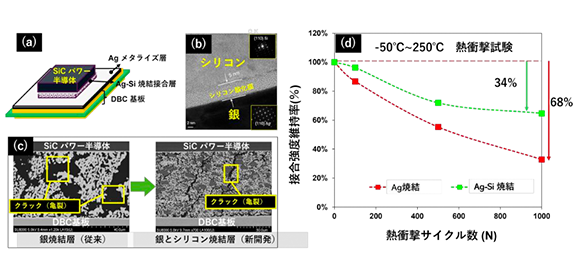
高信頼性、材料コスト削減を実現する銀とシリコンを用いた新接合材料
パワー半導体モジュールの社会実装を一気に加速!
研究成果のポイント
概要
大阪大学産業科学研究所フレキシブル3D実装協働研究所の陳伝彤(チン・テントウ)特任准教授(常勤)らの研究グループと株式会社ダイセルは、銀(Ag)とシリコン(Si)の複合焼結材料の新開発に成功しました。
この新開発材料は、銀のみを使用した従来材料と比較し、厳しい熱衝撃試験後の結果において(-50℃〜250℃で1000サイクル)、約2倍の強度保持率を達成しています。この材料を使用することで、極めて高い信頼性を維持しながら、材料コストの削減を実現する高性能パワー半導体の製造につなげることができます。
従来材料の課題
脱炭素化の社会において、EV(電気自動車)の普及に欠かせないのが「SiC(炭化ケイ素)パワー半導体」です。この半導体は、電力変換ロスを大幅に低減し、機器の小型化や、CO2排出量削減に大きく貢献します。その一方で、200℃を超える高温環境下では動作上の課題を抱えており、その課題に対して、安定的な動作を保証するための耐熱・放熱技術や、構造信頼性を維持する材料の開発が遅れていました。
この高温動作の課題に対しては、現在までに銀ナノ粒子(粒径<100nm)焼結接合技術の活用が主に検討されていますが、それも厳しい熱衝撃試験(-50〜250℃)では、銀接合層と半導体デバイス接合界面(境界)に亀裂が発生したり、構造が破壊されるなど、多くの課題が残されていました。
新開発材料の特徴
今回の新接合材料では、銀とシリコンの接合界面におけるシリコン表面に酸化膜ができることで、低温界面が確実に形成され、低い熱膨張係数の接合材料を実現し、界面亀裂の発生および構造破壊の問題が大幅に改善されました(図1)。さらにシリコンの添加量を調整することにより熱膨張係数の制御が可能となります。
今回の研究で新開発した銀とシリコンの複合焼結材料をSiCパワー半導体とDBC基板(Cu回路付きセラミック基板)の接合材料として使用することで、SiCパワー半導体と接合材料の熱膨張ミスマッチを低減させ、厳しい使用環境においても接合界面の亀裂や構造破壊が起こりにくくすることができ、優れた接合信頼性を得ることが可能になります。さらに、シリコンを加えることにより、従来の銀のみの接合材料と比較して材料コストの削減につながることが期待されます。
この成果は、SiCパワー半導体の長寿命化と、その実装構造の信頼性向上、ならびに接合材料コストの削減につながります。社会におけるEV(電気自動車)への応用など、新世代パワー半導体モジュールの社会実装を一気に加速することが期待されます。
図1.(a)SiCパワー半導体とDBC基板との接合構造(b)銀とシリコンの接合界面におけるシリコン表面の酸化膜(c)同じ熱衝撃試験での1000サイクル後の構造内部の劣化比較。銀のみを使用した従来材料の接合構造と比較し、クラック(亀裂)が小さくなり数も減少(d)厳しい熱衝撃試験(-50℃~250℃)において、銀とシリコンの複合焼結材料は、銀のみの従来材料と比較し接合強度維持率が約2倍に。
