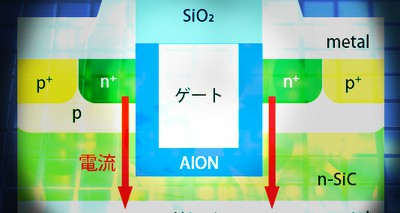
Development of Low-energy-loss and High-reliability Silicon Carbide Transistor with AlON High-k Gate Dielectric
Contributes to Realizing A Low Carbon Emission Society
A group of Osaka University researchers (Assistant professor Takuji HOSOI and Professor Heiji WATANABE of the Graduate School of Engineering), Professor Tsunenobu KIMOTO at Kyoto University, and researchers at ROHM Co., Ltd. and Tokyo Electron Limited have succeeded in developing high-performance and high-reliability SiC MOSFETs by implementing high-permittivity aluminum oxynitride (AlON) gate dielectrics.
Thanks to AlON high-k gate dielectrics, 90% reduction in gate leakage current and 50% improvement of dielectric breakdown field were achieved.
This development leading to certainly improve SiC MOSFET will contribute to realizing a low carbon emission society.
This achievement was presented in International Electron Device Meeting (IEDM) by the IEEE on December 10, 2012.
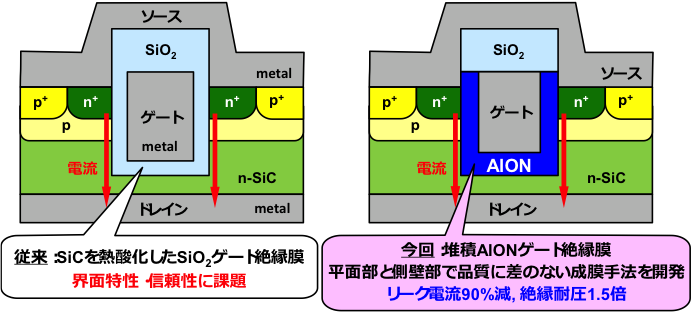
Thesis and authors
" Performance and Reliability Improvement in SiC Power MOSFETs by Implementing AlON High-k Gate Dielectrics ," T. Hosoi, S. Azumo*, Y. Kashiwagi*, S. Hosaka*, R. Nakamura**, S. Mitani**, Y. Nakano**, H. Asahara**, T. Nakamura**, T. Kimoto***, T. Shimura, H. Watanabe
Key: Osaka University, *Tokyo Electron Ltd., **ROHM Co. Ltd., ***Kyoto University
Related links
